טיפול באמצעות אטומי מימן לשיפור אמינות ה- NBTI בתהליכי ייצור בטמפרטורה נמוכה
פתרון לבעיית ה־NBTI בתהליכי ייצור רגילים של מעגלים משולבים
חוסר יציבות בהטיית טמפרטורה (Bias temperature instability או BTI בקיצור) היא תופעה מוכרת, המופיעה עם הזמן בטרנזיסטורים מסוג MOSFET ועלולה לפגוע באופן משמעותי בביצועי ואמינות הטרנזיסטור. בדרך כלל היא באה לידי ביטוי כעליה הדרגתית ובלתי־רצויה במתח הסף של המכשיר וירידה בזרם השפך. מקורה של תופעת ה־BTI הוא בפגמים בחומר הדיאלקטרי שממנו בנוי השער ובנקודת המגע עם תעלת הסיליקון, והתוצאה היא לכידת המטען החשמלי שעובר בתעלת ההולכה.
עבור טרנזיסטורים העשויים מחומר N, שבהם מופעל מתח חיובי על השער, הדאגה העיקרית היא הילכדות אלקטרונים בחומר הדיאלקטרי בעל המקדם הגבוה. בזכות פער האנרגיה הגדול שלה, כיום משמשת שכבה ננומטרית דקה של תחמוצת סיליקון (SiO2) בשערים ממתכת/חומר דיאלקטרי בעל מקדם גבוה, כמבודד להקטנת הילכדות האלקטרונים ולשיפור אמינות ה־PBTI (BTI חיובי).
לעומת זאת, בטרנזיסטורים מחומר P, מלכודות בשכבת ה־SiO2 עצמה ובנקודת המגע בין החומרים מובילות לתופעת ה־NBTI (BTI שלילי). באופן מסורתי, גידול שכבת ה־SiO2 נעשה בטמפרטורות גבוהות (~1000°C ומעלה) או על ידי חשיפה לטמפרטורות גבוהות דומות במהלך הוספת מטען ('זיהום') לשערי המקור/שפך בשיטת 'תחילה השער' (Gate-first). התוצאה היא שכבת SiO2 באיכות גבוהה עם שיעור פגמים זניח. על מנת לאפשר שימוש בשערים ממתכות שונות, התעשייה עברה לשיטת ייצור בשם 'החלפת שער' ברמת טכנולוגיה 32nm שבה מושתל השער הסופי רק לאחר הוספת המטען ('זיהום'). בתהליך זה, שהפך לתקן בתעשייה, משתמשים בתהליכי ליבון מהירים (בטמפרטורה של ~900°C) לשיפור אמינות, כדי לוודא ששכבת החומר הדיאלקטרי נחשפת לטמפרטורה הגבוהה הנחוצה להקטנת שיעור הפגמים.
אבל מה קורה אם אי אפשר להשתמש בטמפרטורה גבוהה בתהליך?
לאחרונה הוצעה שיטה חדשה בשם (Sequential 3D Integration (יישום תלת-ממדי לפי הסדר)) לייצור שבבים שתאפשר לחוק מור להמשיך להתקיים. בשיטה זאת מונחות שכבות חומר זו על גבי זו לפי הסדר במבנה המזכיר קומות מגורים. אולם, בייצור השכבות העליונות אי אפשר להשתמש בטמפרטורה גבוהה (>600°C) מכיוון שהיא תפגע בטרנזיסטורים ובחיבורים שכבר קיימים בשכבה התחתונה. מגבלות טמפרטורה מסוג זה מציבות אתגרים חדשים בפני יצרני השבבים למחצה, כולל האתגר שבייצור שער בעל רמת אמינות מספקת. כששכבת ה־SiO2 לא נחשפת לטמפרטורה גבוהה במהלך הגידול או ייצור הטרנזיסטור, נוצרים על פני השטח שלה פגמים בצפיפות גבוהה שגורמים לתופעת ה־NBTI הבלתי־רצויה.
צוות המחקר ב־imec, בעזרת הקבוצה של פרופ' טיבור גרסר מאוניברסיטת וינה לטכנולוגיה ופרופ' ו. אפאנאסב ופרופ' א. שטסמנס אוניברסיטת לוון, פיתח תהליך חדש לשיפור איכותן של שכבות ה־SiO2 בטמפרטורות נמוכות יותר, וכך גם משפר את אמינותם של טרנזיסטורים מסוג pMOS לתופעת ה־NBTI, ללא צורך בליבון בטמפרטורות גבוהות. הפיתוח מבוסס על הבנת התהליך ברמת האטום, מנגנון ההיווצרות וההתנהגות החשמלית של פגמים בשכבת ה־SiO2.
איתור המלכודות בשכבת ה־SiO2 (בטמפרטורה נמוכה)
השלב הראשון במציאת פתרון לשיפור אמינות ה־NBTI בטמפרטורה נמוכה היה לזהות את הפגם שגורם לתופעת ה־NBTI. הצוות שלנו השתמש במודל Comphy (שפותח ביחד עם הקבוצה של פרופסור גרסר באוניברסיטת וינה לטכנולוגיה, שהוא גם אחד ממחברי המאמר הזה) למדידת החתימה החשמלית של ה־NBTI בפגמים שנוצרו על גבי שכבת ה־SiO2. לאחר מכן השווינו את רמת האנרגיה המשוערת של המלכודות בפער האנרגיה של תחמוצת הסיליקון (SiO2) לרמות האנרגיה שחושבו ממבנים ידועים של פגמים בתחמוצת הסיליקון (SiO2).
במחקר מקדים זה זוהה מרכז ההידרוקסיל־E' – פגם בתחמוצת הסיליקון (SiO2) שבו המבנה Si-O-Si הופך למבנה Si-O-H – כגורם הסביר ביותר להיווצרות הפגמים. הפגם הזה שכיח יותר כשקשרי Si-O-Si נמתחים על ידי העומס המכני שנוצר בשל אי ההתאמה בין אטומי ה־Si ו־SiO2 שבשריג. כשבתהליך הייצור אטום מימן שבו חסר אלקטרון מתקרב לאתר Si-O-Si מתוח, הוא נוטה להתחבר לאטום החמצן (ליצירת קשר Si-O-H) ומשאיר מאחור רדיקל סיליקון (אטום סיליקון עם אלקטרונים לא מזווגים), שבהמשך עלול ללכוד אלקטרון ערכיות מתעלת הסיליקון של הטרנזיסטור כשזורם בה זרם חשמלי. (הערה: לאידוש אטום הסיליקון עם האלקטרונים הלא מזווגים יהיה צורך להביא לאתר אטום מימן טעון נוסף).
תרשים 1: (משמאל) השוואה בין רמות האנרגיה שחושבו עבור מבני פגם ידועים בתחמוצת סיליקון (SiO2) לעומת רמות האנרגיה של חתימת ה־NBIT כפי שנאמדו באמצעות מודל Comphy. המועמד הסביר ביותר הוא פגם בהידרוקסיל־E'. כמו כן, נשללו כמה גורמים נפוצים, ובהם המקום הפנוי לאטום חמצן. (מימין) סידור האטומים של מבני הפגם השונים.

תרשים 1
הפגמים בהידרוקסיל־E' צפויים להיווצר גם בשכבות SiO2 איכותיות שגדלו בטמפרטורה גבוהה. אז מדוע הם נוצרים בצפיפות גדולה יותר בשכבות SiO2 שגודלו בטמפרטורות נמוכות ומדוע הם מובילים לפגיעה באמינות הטרנזיסטור בשל NBTI? על פי השערת היסוד שלנו, בטמפרטורת חמצון נמוכה העומס המכני בין אטומי Si/SiO2 לא משתחרר באותה מידה. התוצאה היא כמות גדולה יותר של קשרי Si-O מתוחים, שהם המקור להיווצרות המלכודות המזיקות. ההשערה הזאת אושרה על ידי תצפיות שבהן הודגם כי שיפור באמינות ה־NBTI מושג רק כשגידול תחמוצת הסיליקון נעשה בטמפרטורה של יותר מ־700°C או כשהיא נחשפת לטמפרטורות האלו. זהו גם טווח הטמפרטורות שבו על פי הממצאים משתחרר העומס המכני בין האטומים.
אידוש הפגמים בטמפרטורה נמוכה באמצעות אטום מימן: תוצאה פורצת דרך
החדשות הטובות הן שבמחקר תיאורטי מקדים שבוצע על ידי שותפינו למחקר מאוניברסיטת וינה לטכנולוגיה, הוצע כי מימן יכול לשמש לאידוש רדיקל הסיליקון במרכזי ההידרוקסיל־E', באופן דומה לרדיקלים שנמצאים על פני שטח גביש סיליקון (הנקראים מרכזי Pb). הדרך הפשוטה לעשות זאת תהיה ליבון בסביבת גז עשיר במולקולות מימן, וזאת אכן השיטה המקובלת בענף ייצור המוליכים למחצה. אבל בעיה אחת עדיין נותרה בעינה: לפי המחקר התיאורטי, אידוש באמצעות מולקולות מימן מצריך השקעת אנרגיה ניכרת (על פי החישובים מחסום אנרגיה >0.65eV). פירושו של דבר הוא שבפועל נדרשות טמפרטורת ליבון גבוהות וזה לא פתרון ישים בשיטות ייצור מסוימות.
לכן חקרנו את האפשרות של חשיפת תחמוצת הסיליקון (SiO2) לכמות גדולה של אטומי מימן (רדיקל H*) מיד לאחר החמצון, על מנת לשפר את אידוש הרדיקלים של הסיליקון במרכזי ההידרוקסיל־E', בתגובה שעל פי הצפי תדרוש כמות אנרגיה נמוכה. לצורך חשיפת הרדיקלים של מימן (H*), פיתחנו תהליך ניקוי יבש בפלזמה מרחוק (במורד הזרם) על גבי כלי בגודל 300mm. תוצאת הטיפול הזה עלתה על כל הציפיות שלנו. אפילו חשיפה בטמפרטורה נמוכה של 100°C הובילה לשיפור משמעותי באמינות ה־NBTI. חשיפת שכבת SiO2 שגדלה בטמפרטורה של 600°C לאטומי H* למשך 10 דקות הובילה ליצירת שכבת SiO2 באיכות שכבר משתווה, ואפילו מעט טובה יותר, משכבת SiO2 שגדלה בטמפרטורה של 900°C ושימשה כביקורת. העלאת טמפרטורת החשיפה ל־300°C, עדיין רחוק מערך הגבול העליון 600°C, שיפרה את איכות תחמוצת הסיליקון לרמה שהתעלתה על זאת של שכבת הביקורת שגדלה בטמפרטורה של 900°C. על פי חקר הקינטיקה של תגובת האידוש באמצעות אטומי H* תחת זמני וטמפרטורות חשיפה שונים, אנחנו מעריכים כי נדרשת בסך הכל אנרגיית שפעול של 0.21eV ולכן אפשר לקבוע כי הטיפול באטומי H* מתאים לתהליכי ייצור בטמפרטורה נמוכה.
איור 2 – השפעת הטיפול באטומי H* על צפיפות מלכודות בשכבת SiO2 שגדלה בטמפרטורה של 600°C (משמאל) לאחר חשיפה בטמפרטורה של 100°C ולאחר חשיפה (מימין) בטמפרטורה של 300°C. כמו כן מוצגת שכבת SiO2 איכותית שגדלה בטמפרטורה של 900°C ושמשה כביקורת.
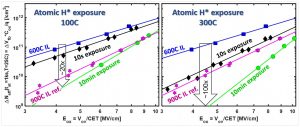
איור 2
חשוב לציין שלאחר הטיפול בטמפרטורה גבוהה או בחשיפה לאטומי מימן בטמפרטורה נמוכה, יש צורך לסיים את השער התלת־ממדי בתהליך סינטור רגיל. זהו שלב ליבון נוסף בסביבת גז עשיר במולקולות מימן שנעשה בטמפרטורה של 400°C–450°C, לשם אידוש הרדיקלים (מרכזי Pb) שנותרו על פני גביש הסיליקון לאחר החמצון. הרדיקלים האלה נחקרו היטב בעבר על ידי הקהילה המדעית ואין לבלבל בינם לבין הרדיקלים בשכבת ה־SiO2, שהם נושא העבודה שלנו.
ההשפעה החיובית על מתח הסף
תופעת לוואי חיובית שבה הבחנו במהלך הטיפול היא שהוא לא רק הקטין את צפיפות המלכודות, אלא גם הגדיל את יעילות השער התלת־ממדי. הסיבה לכך היא הקטנת המטען החיובי הקבוע בתחמוצת הסיליקון, ככל הנראה על רקע אידוש הפגם בהידרוקסיל־E' (בחלק העליון). יעילות העבודה היא פרמטר מפתח בקביעת מתח הסף הנמוך ביותר שאפשר להשיג עבור טרנזיסטור מחומר P. פירושו של מתח סף נמוך הוא שאפשר להגדיל את ביצועי הטרנזיסטור במתחים נמוכים.
מנגנון היווצרות הפגם והאידוש
הצוות שלנו ביצע ניסויים נוספים על מנת להדגים את המנגנון הכללי ליצירת הפגם/אידוש. שכבת SiO2 שגדלה בטמפרטורה של 600°C עברה אידוש על ידי אטומי H* לפני שעברה חמצון חוזר בטמפרטורה נמוכה (450°C). התוצר היה שכבה עם אמינות NBTI נמוכה מאוד, מכיוון שפגמי החמצון הופיעו שוב בחמצון החוזר, ואפילו בצפיפות גדולה יותר, בשל טמפרטורה הנמוכה. עם זאת, הצלחנו לאדש גם את הפגמים החדשים האלה באמצעות חשיפתם לרדיקלים של מימן.
יתר על כן, טיפול באמצעות רדיקל מימן H* בשכבת SiO2 שגודלה בטמפרטורה של 900°C, כלומר שכבה באיכות גבוהה ואמינות NBTI טובה, השיג שיפור איכות נוסף. הניסויים המשלימים האלה מדגימים כי למרות ההבדל בתנאי הגידול והליבון של שכבת ה־SiO2, מנגנוני היווצרות הפגמים והאידוש הם אותם מנגנונים. ככל שהטמפרטורה שבה גדלה שכבת ה־SiO2 נמוכה יותר, כך גדלה צפיפות המלכודות הנוצרות שאותן אפשר לאדש בחשיפה מתאימה לאטומי רדיקל מימן H*, להשגת אמינות NBTI מצוינת.
איור 3 – השפעת הטיפול באטומי H* על צפיפות המלכודות בשכבת SiO2 שגדלה בטמפרטורה של 900°C.
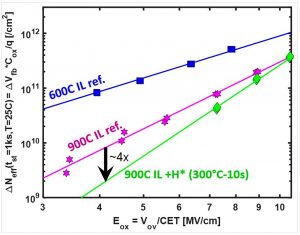
איור 3
המשמעות מעבר לשיטת Sequential 3D (השתלה תלת־ממדית רציפה)
הצגנו גישה חדשה לשיפור אמינות ה־NBTI של טרנזיסטורים מסוג pMOS שייוצרו בתהליך ייצור בטמפרטורה נמוכה, כדוגמת Sequential 3D. אבל התצפיות הנ"ל מצביעות על כך שייתכן שלגישה הזאת יש טווח יישומים רחב מששערנו.
לדוגמה: בתהליך 'החלפת שער', החלפת שלב הליבון בטיפול באטומי מימן יכולה להפוך את כל תהליך הייצור לפשוט יותר. לא רק ששלב הליבון המסורתי מתבצע בטמפרטורה גבוהה מאוד, אלא גם שיש צורך לשתול שער זמני (בדרך כלל עשוי טיטניום־ניטריד + סיליקון אמורפי) לשליטה על הדינמיקה בין הרכיבים הכימיים במהלך תהליך ליבון בטמפרטורה גבוהה ולמניעת זיהום משערי מתכת פחות יציבים. השער הזמני מוחלף לאחר תהליך הליבון בשער המתכת הסופי הנחוץ לצורך השגת מתח הסף הרצוי. הטיפול בשכבת ה־SiO2 באטומי מימן משיג יעילות זהה בטמפרטורות נמוכות יותר ויכול לחסוך את כל השלבים הנוספים של תהליך החלפת השער הזמני. כמו כן, תהליך האידוש החדש יכול להפוך לבסיס לארכיטקטורות טרנזיסטור בייצור המוני, כולל השבחת תהליכי הייצור של טרנזיסטורים מסוג FET (או CFET) או שער מכל הכיוונים Nanosheet או Forksheet, שבהם המרחק בין הטיילים עלול למנוע את יישום השער זמני (עבה יחסית) לפני שלב הליבון.
על המחברים
ג'קופו פרנקו (Jacopo Franco)
ג'קופו פרנקו הוא חבר בכיר בצוות הטכני של קבוצת האמינות והאפיון החשמלי במחלקת האמינות, העמידות והבדיקה המתקדמת ב־imec, בלגיה. הוא בעל תואר B.Sc (משנת 2005) ותואר M.Sc (משנת 2008) מאוניברסיטת קלבריה שבאיטליה, ותואר Ph.D בהנדסת חשמל מאוניברסיטת לוון שבבלגיה (2013). המחקר שלו מתמקד באמינות CMOS ו־FEOL ובפיתוח שערים תלת־ממדיים לטכנולוגיות חדשות (SiGe, Ge, III-V) ושיטות שילוב חדשות (Sequential 3D).

ז'אן פרנסואה דה מרנף (Jean-François de Marneffe)
ז'אן פרנסואה דה מרנף הוא חבר בכיר בצוות הטכני של קבוצת חקר החומרים הכימיים והפיזיקה ב־imec, בלגיה. הוא מחזיק בתואר Ph.D בפיזיקה מהאוניברסיטה החופשית של בריסל (ULB), עם התמחות בסינתזה ואפיון חשמלי/מגנטי של רצועות מוליכות-על רבודות מבוססות נחושת בטמפרטורות גבוהות על בסיס ביסמות. לאחר שעזב את מכון Max-Planck Institute für Festkörperforschung, הוא הצטרף ל־imec בשנת 2001 בתפקיד מהנדס. מאז הוא התקדם למשרת מדען חוקר עם התמקדות בעיבוד חומרים דו־ממדיים, חומרים עם מקדם דיאלקטרי נמוך, חקר טכנולוגיות מסכות חדשות, תהליכי המרה ותבניות מעגליות ובהן איכול שכבה באמצעות אטומים.